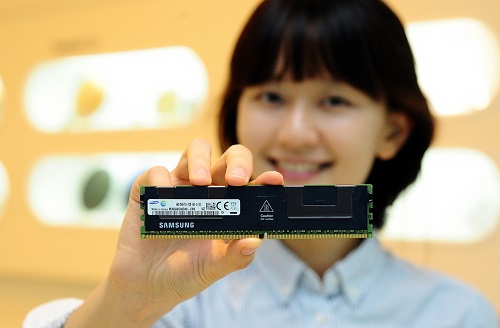
삼성전자는 세계 최초로 3차원 'TSV(Through Silicon Via, 실리콘관통전극)' 적층 기술을 적용한 64기가바이트(GB) 차세대 DDR4(Double Data Rate 4) 서버용 D램 모듈을 양산하기 시작했다고 27일 밝혔다.
64기가바이트 DDR4 D램 모듈은 20나노급 4기가비트(Gb) D램 칩 144개로 구성된 대용량 제품이다. 최첨단 3차원 TSV 기술로 4기가비트 D램을 4단으로 쌓아 만든 4단 칩 36개를 탑재했다.
'TSV'란 D램 칩을 일반 종이 두께의 절반보다 얇게 깎은 후 수백개의 미세한 구멍을 뚫고, 상단 칩과 하단 칩의 구멍을 수직으로 관통하는 전극을 연결한 첨단 패키징 기술이다. 기존 와이어(금선)를 이용한 패키징 방식에 비해 속도와 소비전력을 크게 개선할 수 있다.
삼성전자는 2010년 세계 최초로 TSV기반 D램 모듈을 개발하고 글로벌 서버 고객과 기술 협력을 추진해 왔다. 이어 올해는 TSV 전용 라인을 구축하고 양산 체제에 돌입, 새로운 시장 창출에 나섰다.
이번 64기가바이트 대용량 서버용 DDR4 모듈과 올 하반기 출시되는 글로벌 IT업체들의 차세대 서버용 CPU를 연계해 DDR4 신규시장을 적극 공략해 나갈 예정이다.
삼성전자는 작년 세계 최초로 3차원 V낸드플래시를 양산하고 이번에는 업계 최초로 DDR4 D램에 TSV 기술을 적용한 차세대 제품을 양산함으로써 '3차원 메모리반도체 시대'를 주도하게 됐다.
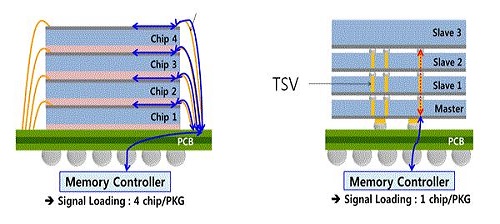
이번 3차원 TSV 기술 기반의 서버용 D램은 기존 와이어(Wire Bonding)를 이용한 D램 대비 동작 속도가 2배 빠르면서도 소비전력을 절반 수준으로 절감했다.
특히 TSV 기술 적용으로 D램에서 속도 지연 문제로 최대 4단까지 밖에 쌓지 못했던 기술 한계를 넘어 더 많은 칩을 쌓을 수 있어 향후 64기가바이트 이상 대용량 제품을 양산할 수 있게 됐다.
백지호 메모리사업부 메모리마케팅팀 상무는 "이번 TSV기반 D램 모듈 양산으로 하반기 업계 차세대 CPU 출시에 맞춘 초절전 솔루션을 제공하고 프리미엄 DDR4 D램 시장을 선점할 수 있게 됐다"고 설명했다.
삼성전자는 하반기 서버 D램 시장이 DDR3 D램에서 DDR4 D램으로 전환되는 트랜드에 맞춰 3차원 TSV 기술을 적용한 64기가바이트 이상의 고용량 DDR4 모듈도 출시해 프리미엄 메모리 시장을 더욱 확대해 나갈 예정이다.
한편 시장조사기관에 따르면 올해 D램 시장은 386억 달러며, 그중 서버 시장이 20% 이상의 비중을 차지할 것으로 전망된다. 특히 클라우딩 컴퓨터의 비중이 지속 증대되고, 서버 시스템에 탑재되는 소프트웨어 종류도 늘고 있어 향후 고성능 서버에서 고용량 D램의 요구가 늘어날 것으로 예상되고 있다.

















